移動体通信用部品・モジュール 飛躍的に技術進化
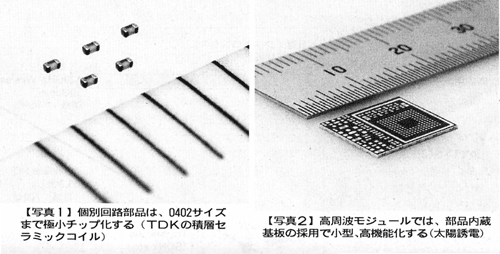
スマートフォンやタブレットPCなどの小型、薄型、多機能化の進展を背景に、個別部品は極小化し、モジュールは小型、薄型で高機能化に向けて技術が高度化する。引き続き、性能、特性に優れた新しい材料を使い、最新のプロセス技術を用いて、移動体通信用の電子部品技術が進化する。
0402サイズまで極小化
移動体通信端末の新製品開発を踏まえ、コンデンサ、インダクタ、抵抗器をはじめとする個別の回路部品の小型化技術が飛躍的な進歩を見せている。チップ抵抗器、積層セラミックコンデンサ、積層インダクタ、さらにはNTCサーミスタ、バリスタなどは0603サイズから0402サイズに極小チップ化。しかも、最近では薄膜技術を応用したLCRが台頭してきた。高周波回路における高精度化に向けた動き。すでにインダクタや抵抗器、さらにはノイズ対策部品の薄膜チップは高周波回路での採用が定着化しているが、ここにきて薄膜コンデンサが0402サイズで開発された。
積層誘電体フィルターをはじめ、チップバランなどは、2×1.25ミリメートルサイズ程度まで一般化し、一部の周波数帯では1.6×0.8ミリメートルサイズまで小型化している。さらに水晶振動子は2×1.6ミリメートルサイズ、1612サイズ、1210サイズへと小型化技術が進展。TCXO(温度補償型水晶発振器)も2520サイズから2016サイズへと小型化。SAWデバイスは、これまでのパッケージングに加え、WLP構造を採用することによって、2ミリメートル角サイズから1ミリメートル角台クラスへと小型化。
アンテナは、セラミック材料による超小型のSMD単機能アンテナやセラミック混合樹脂材料および3次元電極形成技術による筐体組込みアンテナなどの小型化が進む。デュアル、トリプルといった複数の周波数帯に1個のアンテナで対応する複合小型タイプの開発が活発化している。
モジュールも著しく技術進化
移動体通信端末に搭載されるブルートゥース、W―LAN、WiMAX、GPS、ワンセグチューナ、ZigBee用など、各種モジュールにおける技術進展も目覚ましい。これまでのモジュールは薄型で小型面積の基板による微細パターン化、超小型、薄型部品の搭載、さらにはLTCC(低温焼結セラミック基板)の採用などによって、小型、高機能化を推進してきた。これらの技術の高度化に加え、ここにきて部品内蔵基板技術を用いて、小型で大規模回路をモジュール化する技術が注目されている。
銅コア内蔵回路基板などが登場
部品内蔵基板は、多層板の内層回路に電子部品や半導体を印刷形成したものや電子部品や半導体を埋め込んだものなど、様々な技術開発が進んでいる。
基板は、薄くて高周波特性、耐熱性などに優れた材質が利用されているが、ここにきて銅コアを内蔵した回路基板やコアレス回路基板などを用いた部品内蔵基板が登場している。
樹脂系部品内蔵基板は、多層化については基板全体を薄くするためにビルドアップ工法が用いられ、パターン形成に一般的なサブストレート工法を使う。微細化をするためにはアディティブ工法を採用することによって、L(ライン)/S(スペース)=25μm/25μm程度まで超微細化が可能とされる。また、層間を接続するビアホールは面積効率を高めるために極小径化する。
内蔵するSMDは、基板厚みを薄くするために基板内蔵用の極薄チップの開発が活発化している。チップ抵抗器では厚み0.15ミリメートルの製品が登場した。電極も基板内蔵に対応して銅電極を採用し、基板内で銅メッキ接続を可能にしている。
積層セラミックコンデンサは、最新技術として1005サイズの0.05ミリメートル厚で0.1μF、0603サイズの0.05ミリメートル厚では0.01μFを実現。
半導体デバイスの内蔵化は、EWPを用いている例が多い。その中で、半導体パッケージを特殊な技術で薄型にして利用する技術も開発された。最近では、ガリウムひ素(GaAs)アンテナスイッチを内蔵したモジュールが開発されるなど、一段と技術が高度化してきた。