怴崅惈擻嵽椏傗嵟怴僾儘僙僗嵦梡丂崅廃攇晹昳丄傛傝媄弍恑壔

丂崅廃攇晹昳偼丄婡婍偺彫宆壔丄搵嵹偝傟傞儌僕儏乕儖偺崅婡擻壔偵岦偗偨怴惢昳奐敪偑妶敪壔偟偰偄傞丅僗儅乕僩僼僅儞傗僞僽儗僢僩抂枛側偳偺彫宆丄敄宆丄懡婡擻壔偺恑揥傪攚宨偵丄屄暿晹昳偼嬌彫壔偟丄儌僕儏乕儖偼彫宆丄敄宆偱崅婡擻壔傪悇恑丅堷偒懕偒丄怴偟偄崅惈擻嵽椏傪巊偄丄嵟怴偺僾儘僙僗媄弍傪梡偄偰丄崅廃攇晹昳偑恑壔偟偰偄偔丅
敄枌媄弍墳梡偺俴俠俼戜摢
僗儅乕僩僼僅儞傗僞僽儗僢僩抂枛丄奺庬崅廃攇儌僕儏乕儖偺彫宆丄寉検壔丄懡婡擻壔偵岦偗偨怴惢昳奐敪傪摜傑偊丄僐儞僨儞僒丄僀儞僟僋僞丄掞峈婍傪偼偠傔偲偡傞屄暿偺夞楬晹昳偺彫宆壔媄弍偑旘桇揑側恑曕傪尒偣偰偄傞丅僠僢僾掞峈婍丄愊憌僙儔儈僢僋僐儞僨儞僒丄愊憌僀儞僟僋僞丄偝傜偵偼僒乕儈僗僞丄僶儕僗僞側偳偼侽俇侽俁僒僀僘偐傜侽係侽俀僒僀僘偵僔僼僩丅偟偐傕嵟嬤偱偼敄枌媄弍傪墳梡偟偨俴俠俼偑戜摢偟偰偒偨丅崅廃攇夞楬偵偍偗傞崅惛搙壔偵岦偗偨摦偒丅偡偱偵僀儞僟僋僞傗掞峈婍偺敄枌僠僢僾偼崅廃攇夞楬偱偺嵦梡偑掕拝壔偟偰偄傞偑丄偙偙偵偒偰丄敄枌僐儞僨儞僒偑侽係侽俀僒僀僘偱奐敪偝傟偨丅偙偺敄枌僐儞僨儞僒偼丄惷揹梕検乮侽丏俀乗俁倫俥乯偺岞嵎傪±侽丏侽俆倫俥偲嫹岞嵎壔偟丄敄枌嵽椏偲嵟揔側宍忬愝寁偵傛傝丄廬棃斾侾俆侽亾偺崅俻摿惈傪払惉偟偨丅傑偨丄帺屓嫟怳廃攇悢摿惈傕俇丏俉俧僿儖僣乮俀丏俀倫俥乯偲偄偆崅偄摿惈傪幚尰偟偨丅幚憰柺偱偼丄抂巕峔憿傪掙柺抂巕壔偟丄崅惛搙偺愗抐僾儘僙僗傪梡偄傞偙偲偵傛偭偰丄崅偄悺朄惛搙傪幚尰偟偰偄傞丅
傾儞僥僫偼丄僙儔儈僢僋嵽椏偵傛傞挻彫宆偺俽俵俢扨婡擻傾儞僥僫傗僙儔儈僢僋崿崌庽帀嵽椏偍傛傃嶰師尦揹嬌宍惉媄弍偵傛傞鉃懱慻崬傒傾儞僥僫側偳偺彫宆壔偑恑傓丅僨儏傾儖丄僩儕僾儖偲偄偭偨暋悢偺廃攇悢懷偵侾屄偺傾儞僥僫偱懳墳偡傞暋崌彫宆僞僀僾偺奐敪偑妶敪壔偟偰偄傞丅
愊憌桿揹懱僼傿儖僞乕傪偼偠傔丄僠僢僾僶儔儞側偳偼丄俀×侾丏俀俆儈儕儊乕僩儖僒僀僘掱搙傑偱堦斒壔偟丄堦晹偺廃攇悢懷偱偼侾丏俇×侽丏俉儈儕儊乕僩儖僒僀僘傑偱彫宆壔偟偰偄傞丅偝傜偵悈徎怳摦巕偼俀×侾丏俇儈儕儊乕僩儖僒僀僘丄侾俇侾俀僒僀僘丄侾俀侾侽僒僀僘傊偲彫宆壔媄弍偑恑揥丅
俿俠倃俷乮壏搙曗彏宆悈徎敪怳婍乯傕俀俆俀侽僒僀僘偐傜俀侽侾俇僒僀僘傊偲彫宆壔丅俽俙倂僨僶僀僗偼丄偙傟傑偱偺僷僢働乕僕儞僌偵壛偊丄倂俴俹峔憿傪嵦梡偡傞偙偲偵傛偭偰丄俀儈儕儊乕僩儖妏僒僀僘偐傜侾揰悢儈儕儊乕僩儖妏僋儔僗傊偲彫宆壔丅
僽儖乕僩僁乕僗丄倂乗俴俙俶丄倂倝俵俙倃丄俧俹俽丄儚儞僙僌僠儏乕僫丄倅倝倗俛倕倕梡側偳丄奺庬儌僕儏乕儖偑戜摢偟偰偄傞丅偙傟傑偱偺儌僕儏乕儖偼敄宆偱彫柺愊偺婎斅偵傛傞旝嵶僷僞乕儞壔丄挻彫宆丄敄宆晹昳偺搵嵹丄偝傜偵偼俴俿俠俠乮掅壏從寢僙儔儈僢僋婎斅乯偺嵦梡側偳偵傛偭偰丄彫宆丄崅婡擻壔傪悇恑偟偰偒偨丅嵟嬤偱偼晹昳撪憼婎斅媄弍傪梡偄偰丄彫宆偱戝婯柾夞楬傪儌僕儏乕儖壔偡傞媄弍偑拲栚偝傟偰偄傞丅
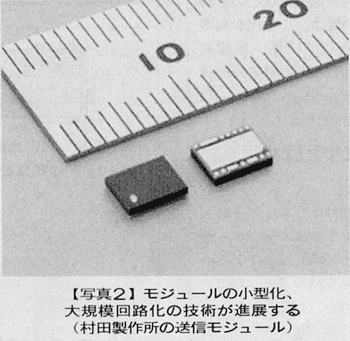
晹昳撪憼婎斅偵摵僐傾撪憼傗僐傾儗僗夞楬婎斅嵦梡
丂晹昳撪憼婎斅偼丄懡憌斅偺撪憌夞楬偵揹巕晹昳傗敿摫懱傪報嶞宍惉偟偨傕偺傗揹巕晹昳傗敿摫懱傪杽傔崬傫偩傕偺側偳丄條乆側媄弍奐敪偑恑傫偱偄傞丅婎斅偼丄敄偔偰崅廃攇摿惈丄懴擬惈側偳偵桪傟偨嵽幙偑棙梡偝傟偰偄傞偑丄偙偙偵偒偰摵僐傾傪撪憼偟偨夞楬婎斅傗僐傾儗僗夞楬婎斅側偳傪梡偄偨晹昳撪憼婎斅偑搊応偟偰偄傞丅
丂庽帀宯晹昳撪憼婎斅偼丄懡憌壔偵偮偄偰偼婎斅慡懱傪敄偔偡傞偨傔偵價儖僪傾僢僾岺朄偑梡偄傜傟丄僷僞乕儞宍惉偵堦斒揑側僒僽僗僩儗乕僩岺朄傪巊偆丅旝嵶壔傪偡傞偨傔偵偼傾僨傿僥傿僽岺朄傪嵦梡偡傞偙偲偵傛偭偰丄俴乮儔僀儞乯乛俽乮僗儁乕僗乯亖俀俆μ乛俀俆μ倣掱搙傑偱挻旝嵶壔偑壜擻偲偝傟傞丅傑偨丄憌娫傪愙懕偡傞價傾儂乕儖偼柺愊岠棪傪崅傔傞偨傔偵嬌彫宎壔偡傞丅
丂撪憼偡傞俽俵俢偼丄婎斅岤傒傪敄偔偡傞偨傔偵婎斅撪憼梡偺嬌敄僠僢僾偺奐敪偑妶敪壔偟偰偄傞丅僠僢僾掞峈婍偱偼岤傒侽丏侾俆儈儕儊乕僩儖偺惢昳偑搊応偟偨丅揹嬌傕婎斅撪憼偵懳墳偟偰摵揹嬌傪嵦梡偟丄婎斅撪偱摵儊僢僉愙懕傪壜擻偵偟偰偄傞丅
丂愊憌僙儔儈僢僋僐儞僨儞僒偼丄嵟怴媄弍偲偟偰侾侽侽俆僒僀僘偺侽丏侽俆儈儕儊乕僩儖岤偱侽丏侾μ俥丄侽俇侽俁僒僀僘偺侽丏侽俆儈儕儊乕僩儖岤偱偼侽丏侽侾μ俥傪幚尰丅
丂敿摫懱僨僶僀僗偺撪憼壔偼丄俤倂俹傪梡偄偰偄傞椺偑懡偄丅偦偺拞偱丄嵟嬤偱偼敿摫懱僷僢働乕僕傪摿庩側媄弍偱敄宆偵偟偰棙梡偡傞媄弍傕奐敪偝傟偨丅偝傜偵丄僈儕僂儉徨慺乮俧倎俙倱乯傾儞僥僫僗僀僢僠傪撪憼偟偨儌僕儏乕儖傕奐敪偝傟偨丅