半導体
次世代ゲート絶縁膜開発の新設計原理の確立
|
物質・材料研究機構ナノマテリアル研究所ナノ立体配置グループと、筑波大学、千葉大学、半導体先端テクノロジーズ(Selete)は、広島大学、大阪大学、早稲田大学ナノテクノロジー総合支援プロジェクトセンターなどと共同で、金属ゲートとhighマイナスk膜(高誘電率ゲート絶縁膜)を用いた極微細CMOSトランジスタの設計に適用できる金属/高誘電体ゲート絶縁膜(high-k材料)界面で起きている電子レベルの現象を説明する理論構築に世界で初めて成功した。 IC(集積回路)の基本となるMOSFET(電界効果トランジスタ)は、電子を取り出すソースと電子を受けとるドレイン、それに電圧をかけて、電子の流れをオン/オフするゲート電極で構成されており、ゲート電極の下には電極から電流が流れ出ないように絶縁膜(ゲート絶縁膜、SiO2)が設けられている。 ICはこのMOSFETの大きさを縮小することで高速化、高機能化を実現してきたが、最近ではあまりに小型化したために多くの問題が出てきている(図1)。 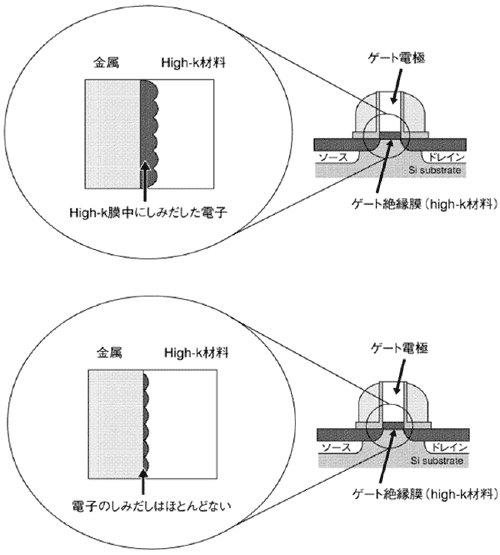 〔図1〕high-k材料を使った場合のこれまでの理論(上)と新理論 そのひとつはゲート絶縁膜が薄くなりすぎたために、電極からの漏れ電流が増加していること。 将来、ゲート絶縁膜の厚さは1nm以下になると予想されており、このままSiO2を使い続けた場合、MOSFETが動作しなくなることが予想されている。 この問題を解決するには、ゲート絶縁膜が厚くなってもSiO2と同等の性能を持つ材料を使うことであり、その材料は高誘電体ゲート絶縁膜、いわゆるhighマイナスk材料が有効とされている。 しかし、high-k材料を用いる場合にはゲート電極材料として多結晶Si(シリコン)より電気的抵抗の低い金属材料を使うことが求められる。これは多結晶Siをゲート材料に使用した場合、high-k材料との界面に微小な絶縁層が形成されるためで、これを避けるためには電気伝導性の高い金属を用いる必要がある。 MOSFETのゲート電極として、これまで使われている多結晶SiはSiO2と化学結合という観点から、共有結合という強固な結合で構成されているという点で類似しており、その類似した様式の結合で界面が構成されていたため適切な動作をさせることができた。 high-k材料は正と負の電荷が引き合って結合ができるイオン結晶であり、金属材料は自由電子が結晶内を自由に動く金属結合で構成されているため、金属/highマイナスk材料界面では結合様式の異なる材料で界面が構成されることになる(図2)。 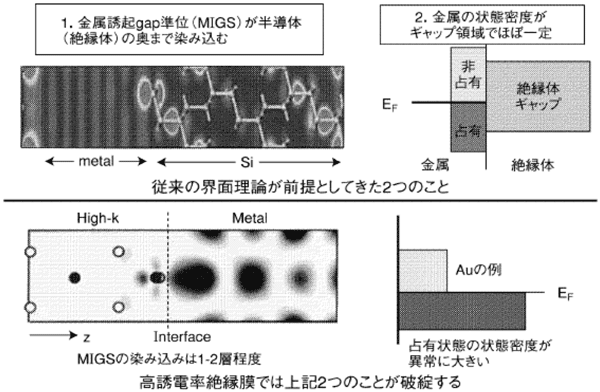 〔図2〕従来の界面理論と高誘電率絶縁膜 ここでは、これまでの理論で金属/highマイナスk界面の電気特性の結果をうまく説明できないという問題が指摘されていた。 そのため、次世代集積回路用を実現するための金属/high-k材料に適用できる新しい原理の確立が望まれていた。 今回、これらの問題を解決するため最先端の計算科学(第一原理計算)を用い、原子レベルで金属/highマイナスk材料界面をそれぞれ異なる結合様式を考慮して一般的に適用できる新原理を構築することに世界で初めて成功、実験的にも証明された。 従来の理論は、金属/酸化物界面で金属の電子が酸化物中に深くしみ出していることを前提として構築されている。これは界面がSiとSiO2で構成されたこれまでの集積回路で適用されてきた理論である。 しかし、今回の計算結果から金属/high-k材料界面では、これらのことが成り立たたなくなっていることが判明するとともに、最新の計算結果で金属/high-k界面では金属側からの電子のしみ出しが極めて小さいことがわかった。この事実をもとに筑波大と千葉大は新しい原理を理論的に構築した(図3)。  〔図3〕一般化された電荷中性点ΦGCNLの構築に成功 この原理に基づくと、high-k絶縁膜中には電荷中性点(「一般化された電荷中性点」)という今回新たに提唱するエネルギーレベルがあり、このエネルギーレベルは接触する金属種類に大きく依存すること、また、「一般化された電荷中性点」の位置によって界面特性が大きく異なることがわかった。 金などの仕事関数の大きな金属がhigh-k膜と界面を形成すると「一般化された電荷中性点」が低エネルギー側にあるため、電子が金属ゲートからhigh-k膜側に移り、フェルミレベルがさらに下がる。 Al(アルミニウム)などの仕事関数の小さな金属では逆に「一般化された電荷中性点」が高エネルギー側にあるため、フェルミレベルが上昇する傾向がある。とくに仕事関数の大きな金属をhigh-k膜上につけた場合の変化は大きく、これによりMOSFETは制御性を失い、機能を発現することができなくなる。 これら新原理から得られた予測結果は広島大学による金/high-k材料界面や物質・材料研究機構のコンビナトリアル手法による系統的な実験、さらにSeleteによる微細な集積回路を使った実験によって実証された。 ナノメートルスケールの極微小金属/high-k材料界面の性質を予言することができる新原理が確立されたことにより、今後の金属ゲート電極とHigh-k膜を用いた極微細集積回路材料選択の指針を与えることが可能となった。 これからの集積回路や将来のナノテクノロジではナノメートルスケールの材料と、それらによって構成される極微小界面が重要な構成要素になる。 今回の研究で得られた結果は、微細な金属/イオン結晶材料(酸化物、窒化物)界面に適用可能で、これにより今後ナノサイズの金属/イオン結晶を使う、MRAMやRRAM、ZnO、GaNを使った素子用電極の開発が大きく進歩すると予想される。 研究グループでは、この理論を用いることにより、金属とhigh-k材料との組み合わせにより生じる界面の性質を理論的に予測することが可能になり、開発が懸念されていたhighマイナスkメタルゲートを用いたトランジスタの2010年までの実用化にメドが立ったとしている。 <用語説明> ◇メタルゲート=集積回路において電子の流れを制御する「ゲート」が金属で構成されているもの。これまでは多結晶Siが使われていたたが、電気抵抗の観点からより抵抗率の低い金属材料が求められている。 ◇high-k=誘電率の高い酸化物材料。従来はSiO2が使われていた。今後はHfO2が主流になるとされている。将来材料としてLa2O3も検討されている。 ◇フェルミレベル=金属中の電子のエネルギーがとるもっとも高いエネルギー値。 ◇一般化された電荷中性点=電荷には負の電荷をもつ電子と正の電荷を持つホールがあるが、それらのエネルギーのバランスが取れるエネルギー準位。 ◇コンビナトリアル手法=材料の組成や成長条件を系統的に一度に変化させて、新しい材料や成長条件を効率的に見つける方法。1995年頃から日米で同時に提案された技術。薄膜合成では日本の技術が世界をリードしている。 ◇MRAM(Magnetic Random Access Memory)=2つの磁性体の間に極薄膜の絶縁体を入れて構成する次世代メモリー。電流の抵抗が磁性の方向で変わることを利用して記録のある、なしを判断する。 ◇RRAM(Resistivity Random Access Memory)=特殊な酸化物が電圧を加えると抵抗の変化を示すことを利用したメモリー。MRAMと並んで次世代メモリーとして期待されている。 <資料提供:独立行政法人物質・材料研究機構>
|