�����̐����Z�p
EUV���\�O���t�B�p�}�X�N���������u���J��
|
�Ȋw�Z�p�U���@�\�i�i�r�s�j�̌����O���[�v�͂��̂قǁA���w���ɕ���ꂽ�K���X���̌������⑽�w���������ɍ��������ٕ��ɋN������ʑ����ׂ̂R�������ώ@���\�ȋɒ[���O���i�d�t�u�j���������J���B�����p���ċɒ[���O�����\�O���t�B�i�d�t�u�k�j�p�}�X�N��̔��ׂȈʑ����ב��̊ώ@�ɐ��E�ŏ��߂Đ��������B �����̐����Z�p�́A�Q�N�ɂS�{�̑��x�ō����x�����i�݁A�Q�O�O�X�N�ɂ͂R�Q�i�m���[�g���̍ŏ����������k�r�h�̎��p�����\�z����Ă���B�����̃f�o�C�X�̔��ׁE�����x���͘I�������̒Z�g�����ɂ���Ď�������Ă��Ă���B���݂́A�g���P�X�R�i�m���[�g���̂`���e�i�t�b���A���S���j���[�U�[���p�����Ă���B���̐�̒Z�g�������Ƃ��Ă͂e�Q���[�U�[�����҂���Ă������A���w�n���\������ޗ��b���e�@�Q�ɕ����ܐ��̖�肪���邽�߁A�ŋ߂͔g��13.5�i�m���[�g���̋ɒ[���O�����\�O���t�B�����ڂ���Ă���B �d�t�u�k�I�����u�͂��łɎ��p���̌��ʂ��������Ă��邪�A�d�t�u�k�p���w�����`���������ˌ^�}�X�N�̖������ɑ����̋Z�p�I�ۑ���c���Ă���B�R�Q�i�m���[�g������̃}�X�N�̑��w���\�ʂƋz���̕����̍ŏ����׃T�C�Y�͂R�O�i�m���[�g���Ƃ���Ă���B����ɑ��w���ɓ��L�Ȗ��Ƃ��āA�K���X���̌�����������ٕ̈��ɋN������ʑ����ׂ̌������K�v�ƂȂ�B ���w���\�ʂ̌��ׂɂ��Ă͏]���̐^�O���i�u�t�u�j�̎U���ɂ�鑪��̍��x���Ō������ł���ƍl�����Ă��邪�A���w���ɕ���ꂽ�[�������ٕ̈��ȂǂɋN������ʑ����ׂ̌����́A�]���@�ł͕s�\�ł���B���̂��߁A�d�t�u�k�p�}�X�N�̕\�ʁE�z���̃p�^�[���̌��ׂ݂̂Ȃ炸�A���w�������̌��ׂ̍�����������\�Ȍ����@�����߂��Ă���B ���l�Ȍ����́A���̔����̂l�h�q�`�h�������Ői�߂��Ă���A���[�U�[�v���Y�}����̂d�t�u���̃}�C�N���r�[����팟���ʂɏƎ˂��A���̈Î��쑜���Q�O�{�̃V���o���c�V�����g���w�n�ɂ��g�債�Ăw���b�b�c�J�����Ŋώ@����Ƃ������݂��s���Ă���B�������A���̌����@�͎U���������o��������̂��߁A���ׂ̗L����m�邱�Ƃ͂ł��邪�A���ׂ̃T�C�Y�A��ʂȂǂ̏��͓����Ȃ��Ƃ̂��ƁB ���̌����ŊJ����i�߂Ă���d�t�u�������V�X�e���͐}�P�̂悤�Ȃ��́B 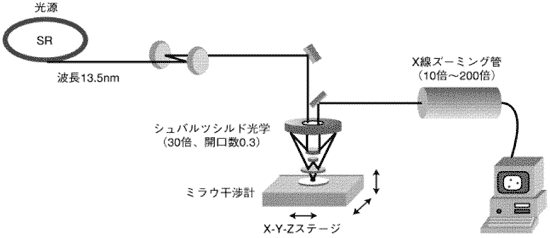 �k�}1�lEUV�}�X�N�����̂��߂̋ɒ[���O���������̍\�� ���̑��u�́A�R�O�{�̃V���o���c�V�����g���w�n�ƂQ�O�O�{�܂ł̑��g�傪�\�Ȃw���Y�[�~���O�ǂō\������A�I�����Ɠ���g����13.5�i�m���[�g���̂d�t�u���Œ��ڃ}�X�N�̑����g��ώ@����B���w�n�̗��_�I�ȉ𑜓x�͂Q�O�i�m���[�g���ŁA�}�X�N�ʏ�̂R�O�i�m���[�g���ȏ�̌��ׂ̊ώ@���\�ł���B �܂��A�g��13.5�i�m���[�g���̌��͈ꕔ���w���߂��邽�߁A����ɂ��K���X���̌�������ٕ��ɋN������ʑ����ׂ̌`��E�傫���Ȃǂ̑��w���\�������̂R�����\�����������邱�Ƃ��ł���B ��ɋ[�����ׂ�݂��A���̏�ɑ��w�����`���������̒f�ʂ��}�Q�ŁA�[�����ׂ̍�����T�C�Y�ɂ���Ă͍ŏ�w�ւ̉e���������Ă��܂��B 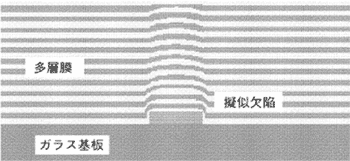 �k�}2�l�[�����ׂ̖͎��} �}�R�͍����ɗp�����K���X��ɂ��炩���ߍ쐬�����[�����ׂ̒f�ʂ̓��ߓd�q���������B  �k�}3�l�[�����ׂ̓��ߓd�q�� ��Ɍ`�����������T�i�m���[�g���A���X�O�i�m���[�g���̃p�^�[���̏�ɑ��w�����`������ƁA�ŏ�w���ł͕\�ʂł̎U���������o�ł��Ȃ��قǂ̂Ȃ��炩�ȓˋN�ƂȂ��Ă���B �}�S�i���j�͊J���������u�ɂ��[�����ׂ̊ώ@���ʁB�[�����ׂ͂ǂ�������T�i�m���[�g���A�����S�O�O�}�C�N�����[�g���ŁA�}�̏㕔���畝�X�O�A�P�O�O�A�P�P�O�i�m���[�g���ɑΉ����Ă���A���ꂢ�Ɋώ@�ł��Ă���B�}�S�i���j�͕��X�O�i�m���[�g���̋[�����ׂ̊g�呜�B
100nm�A110nm(����5nm�A����400��m)�̌���(b)��90nm�̊ώ@�� �}�T�͕��T�O�O�i�m���[�g���̋[�����ׂ̊ώ@��łQ�{�̃��C���Ƃ��Ċώ@����Ă���B����͐������L���A�[�����ׂ̗��T�C�h�̃G�b�W�Ő������ʑ��ω����Ƃ炦�Ă��邽�߁B  �k�}5�l500nm�̋[�����ώ@�� ���̌����ł́A�d�t�u��������p���ċ[�����ׂ̊ώ@��i�߁A���߂đ��w�������̈ʑ����ב��̊ώ@�ɐ��������B�d�t�u�������ł͕\�ʂ̌`��Ɉˑ����邱�ƂȂ��A�����̔��˗����z���Ƃ炦�邱�Ƃ��\�Ȃ��Ƃ������Ă���B ����̐��ʂ͋[�����ׂł��邪�A���w�������̌��ׂ�\�ʂ̌`��Ɉˑ����邱�ƂȂ����o�\�Ȃ��Ƃ����炩�ɂȂ�A���w���\�ʏ�̌��ׂ����w���Ɍ�������ꂽ�K���X���̌��ׂ������\�ł��邱�Ƃ𖾂炩�ɂ����B ����͑��u���[�J�[�Ƌ����ŁA�����E���𑜓x�Ȍ������u�̊J����i�߂�ƂƂ��ɁA���ߍ����ׂ��ǂ��܂Ńf�o�C�X�ɉe����^���邩�ɂ��Ă̒�ʓI�Ȍ������s���A�d�t�u�k�p�}�X�N�̖�������i�߂�Ƃ��Ă���B �������F�Ȋw�Z�p�U���@�\��
|

